|
| ���i�� |
���i�ʐ^
|
���@�@�� |
| BGA |
 |
��K�͏W�ω�H(LSI)Package)�̈��B�l�p�̏�����PCB�̏��LSI Bare chip�� �ڂ��ė��ʂ�2����Array�͗l�̔����^�[�q��z�u���Ă��������B
�[�q��Solder���g�p����ꍇ�������B
225~460Pin��Package�����p������Ă���B �[�q��������LSI Package�����^���\�Ȃ̂ōŋߒ��ڂ���Ă���
�A�����JMotorola�Ђ��J�����������ďo�퓙�ɍ̗p�������Ƃ����y�̌_�@�ɂȂ�B
���݂͒����^������(ASIC)�A�����ÓI����(SRAM)����Package�Ƃ��č̗p���Ă���B
�ŋ߃f�U�C�������l������Ă��ăZ���~�b�N����g�������i�A�v���X�`�b�N�e�[�v����Ƃ��Ďg�������i��������B
PCB���g�p�������i�ɂ͗��ʔȊO��4~6�w�̑��w����g�������i���J������Ă���B
|
| MLB |
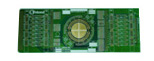 |
- ���w�ƊO�w��H�������̍\����PCB�ŗ��̔z���ɂ�鍂���x���i����
�y��
�@�z�������̒Z�k�\�Ȑ��i�B
- ���p�p�x: ��ɑ�^Computer�APC�A�ʐM�����A���^�Ɠd�@��ȂǂɎg��
���B
|
| HDI |
 |
High Density Interconnect(�g�їp �����x�A����H)
�ˏ��ʐM�Y�Ƃ̋}�����Ƌ��ɍ����x�A���w���ɑΉ������H�@��
������
�ꊇ�ϑw�@�ɂ�鑽�w����E�킵�Ēi�K�I�ɑw���`���A
Micro via�y��
Fine Pattern���`�������V�K�����H�@�̑��w���i�B
|
| FCBGA |
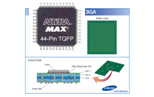 |
Filp Chip Ball Grid Arrays
��Packaging�t��Pin(PGA)��Lead(QFP)�ʂ̑����Ball���g��Packaging�Z�p�B���i�̈����ʐς��k�߁A�O���[�q���o�Ȃ��������� �m�C�Y�ɂ������B���A�O����Pin���o�Ă��Ȃ��̂ŁA��50%���炢�̑傫�������点��B
|